产生焊接空洞的根本原因为锡膏熔化后包裹在其中的空气或挥发气体没有完全排出,影响因素包括锡膏材料、锡膏印刷形状、锡膏印刷量、回流温度、回流时间、焊接尺寸、结构等。
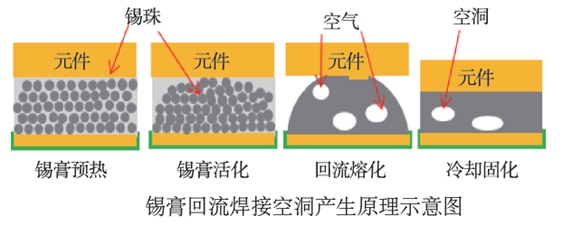
IC芯片封装技术类型 :LGA、PGA、BGA
作为一名SMT工程师,如果不掌握SMT表面组装组装工艺,就很难去分析与改善工艺,而了解组装工艺流程之前,需要掌握表面组装元器件的封装结构,接下来我们深入浅出的针对封装结构与组装工艺两部分进行详细解析。
SMT表面组装元器件的封装形式分类表面组装元器件(SMD)的封装是表面组装的对象,认识SMD的封装结构,对优化SMT工艺具有重要意义。SMD的封装结构是工艺设计的基础,因此,在这里我们不按封装的名称而是按引脚或焊端的结构形式来进行分类。按照这样的分法,SMD的封装主要有片式元件(Chip)类、J形引脚类、L形引脚类、BGA类、BTC类、城堡类,如下图所示。
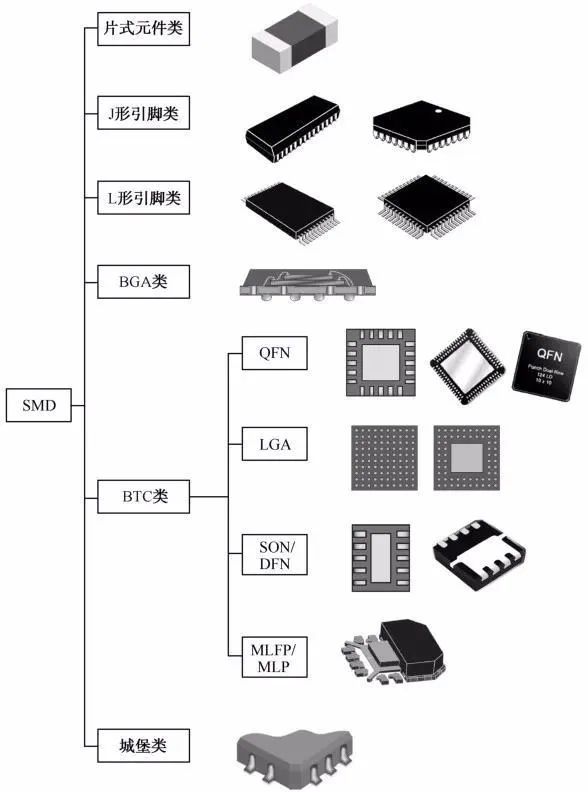
电子元器件SMD的封装分类
▊BGA类封装介绍 :
1. BGA类封装(Ball Grid Array),按其结构划分,主要有塑封BGA(P-BGA)、倒装BGA(F-BGA)、载带BGA(T-BGA)和陶瓷BGA(C-BGA)四大类,如下图所示。
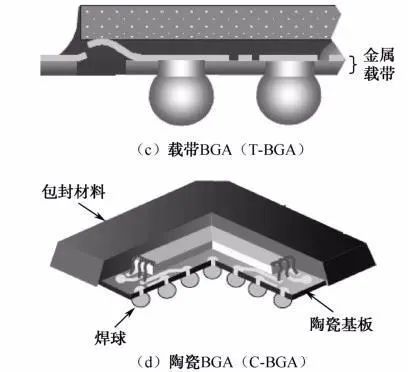
▊BTC类封装介绍:
路板上的底部焊端类器件BTC(Bottom Terminal Component)应用非常广泛,比如焊球阵列器件(BGA/CSP/WLP/POP)及QFN/LLP等特殊器件,BTC类封装在IPC-7093中列出的BTC类封装形式有QFN(Quad Flat No-Lead package)、SON(SmallOutline No-Lead)、DFN(Dual Flat No-Lead)、LGA(land Grid Array)、MLFP(Micro Leadframe Package),如下图所示。
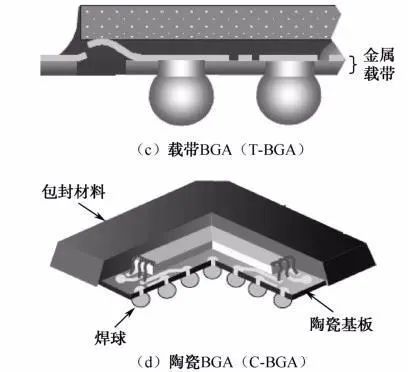
其中,QFN 是一种无引脚封装,呈正方形或矩形,封装底部中央位置有一个大面积裸露焊盘用来导热,通过大焊盘的封装外围四周焊盘导电实现电气连结。由于无引脚,贴装占有面积比 QFP小,高度 比 QFP 低,加上杰出的电性能和热性能,这种封装越来越多地应用于在电子行业。
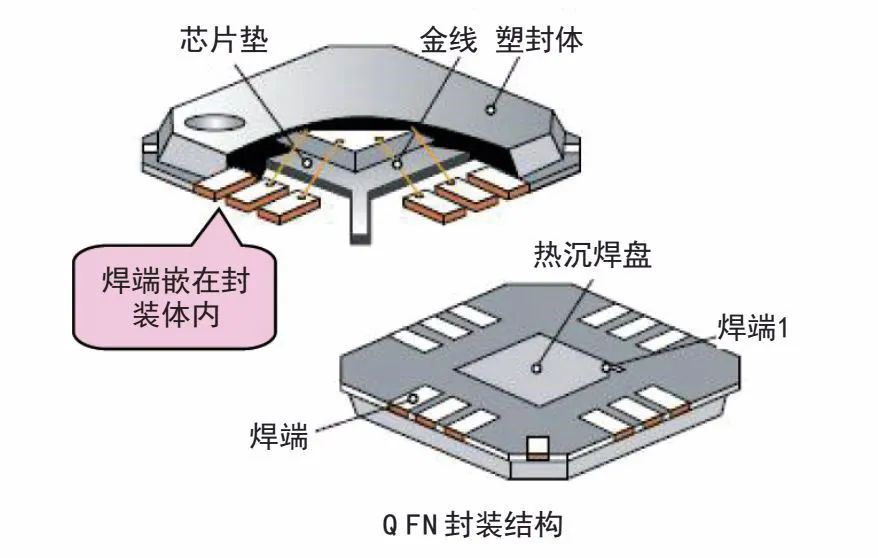
QFN热沉焊盘空洞控制是QFN焊接工艺难题之一,也是业界的难题之一。
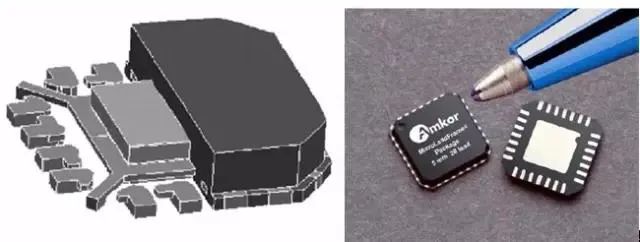
QFN元件三维剖视图和实物外观
由于小尺寸封装携带高功率芯片的能力越来越强,像QFN这样的底部终端元件封装就越来越重要。随着对可靠性性能的要求不断提高,对于像QFN这种封装中的电源管理元件,优化热性能和电气性能至关重要。此外,要最大限度地提高速度和射频性能,降低空洞对减少电路的电流路径十分重要。随着封装尺寸的缩小和功率需求的提高,市场要求减少QFN元件热焊盘下面的空洞,因此必须评估产生空洞的关键工艺因素,设计出最佳的解决方案。
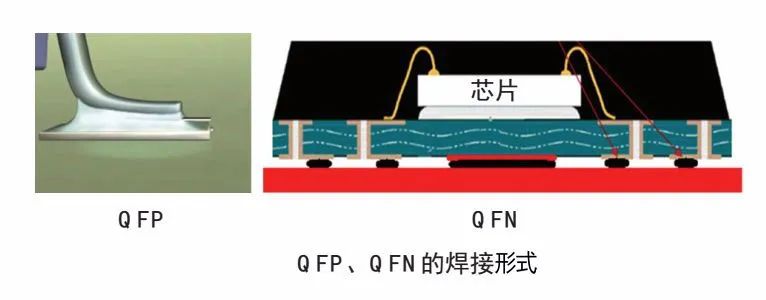

QFN 封装具有优异的热性能,主要是因为封装底部有大面积散热焊盘,为了能有效地将热量从芯片传导到 PCB 上,PCB 底部必须设计与之相对应的散热焊盘以及散热过孔,散热焊盘提供了可靠的焊接面积,过孔提供了散热途径。因而,当芯片底部的暴露焊盘和 PCB 上的热焊盘进行焊接时,由于热过孔和大尺寸焊盘上锡膏中的气体将会向外溢出,产生一定的气体孔,对于 smt 工艺而言,会产生较大的空洞,要想消除这些气孔几乎是不可能的,只有将气孔减小到最低量。
LGA全称“land grid array”,或者叫“平面网格阵列封装”,即在底面制作有阵列状态坦电极触点的封装,它的外形与 BGA 元件非常相似,由于它的焊盘尺寸比 BGA 球直径大 2~3 倍左右,在空洞方面同样也很难控制。并且它与 QFN 元件一样,业界还没有制定相关的工艺标准,这在一定程度上对电子加工行业造成了困扰。

BGA的全称叫做“ball grid array”,或者叫“球柵网格阵列封装”。目前,绝大部分的intel移动CPU都使用了这种封装方式,例如intel所有以H、HQ、U、Y等结尾(包括但不限低压)的处理器。
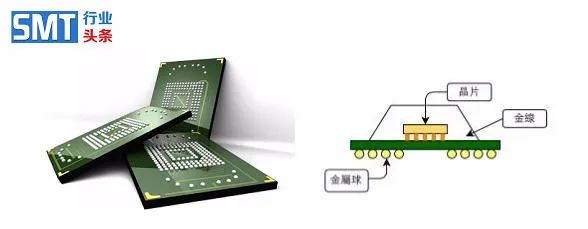

BGA可以是LGA、PGA的极端产物,和他们可以随意置换的特性不同,BGA一旦封装了,除非通过专业仪器,否则普通玩家根本不可能以正常的方式拆卸更换,但是因为是一次性做好的,因此BGA可以做的更矮,体积更小。
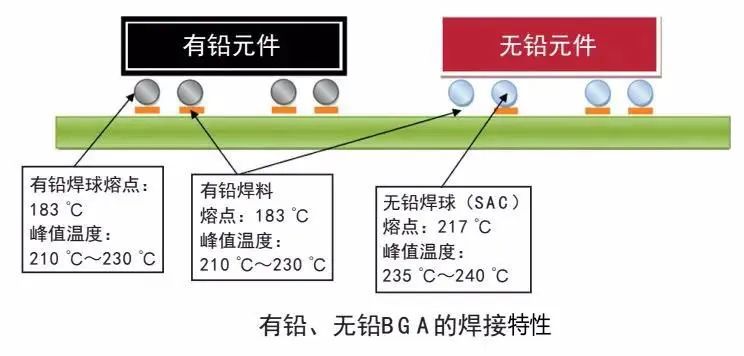
BGA芯片焊点主要缺陷有:空洞,脱焊(开路),桥接(短路),焊球内部裂纹,焊点扰动,冷焊,锡球熔化不完全,移位(焊球于PCB焊盘不对准),焊锡珠等。
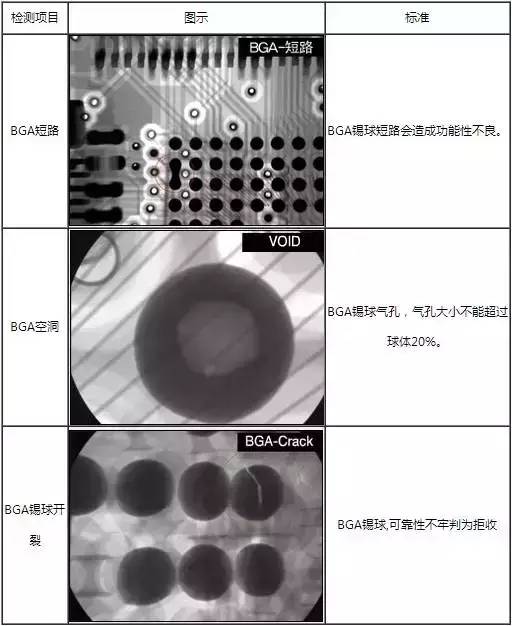
影响BGA空洞的因素 : BGA在焊接过程中形成焊点时,一般会经历二次塌陷的过程。第一个过程是焊膏先熔化,元件塌落下来;第二个过程是焊料球也熔化再次塌落,最终形成一个扁圆形的焊点。而从实际情况看,焊点空洞多发生于焊球底部与焊盘之间的位置,其受焊接过程中助焊剂挥发影响较多,因此,工艺曲线与焊膏是影响焊点空洞形成的两个最为重要的因素。
BGA区域出现空洞的几率一般比较高。PCB设计、焊料选择、焊接工艺(尤其无铅与混装工艺)、回流气氛(真空炉与氮气)、回流参数等都会对空洞的形成与控制有不同程度的影响。
X射线在SMT行业中已经广泛应用于检测BGA的气泡大小、空洞率、最大气泡尺寸。BGA空洞的验收标准大部分是遵从IPC-A-610D(8.2.12.4 表面安装阵列-空洞),IPC标准明确规定了X射线检测结果中任何焊料球的空洞大于25%视为缺陷。
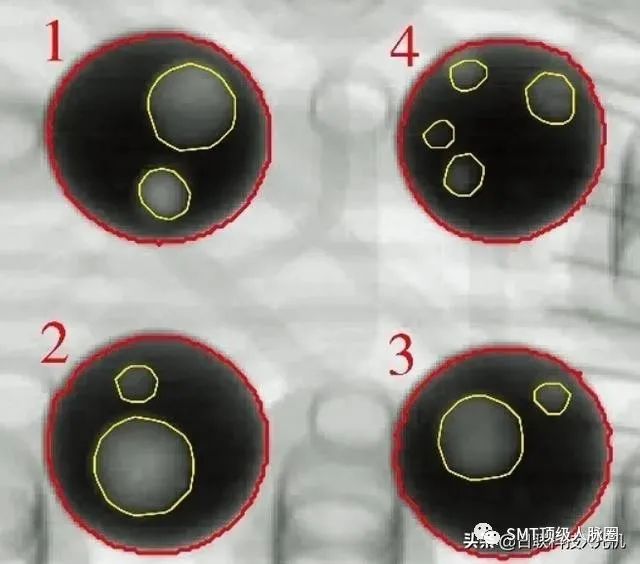
审核编辑:郭婷

 铁锚
铁锚 大桥
大桥 金桥
金桥 京雷
京雷 天泰
天泰 博威合金BOWAY
博威合金BOWAY 马扎克Mazak
马扎克Mazak 威尔泰克
威尔泰克 迈格泰克
迈格泰克 斯巴特
斯巴特 MAOSHENG贸盛
MAOSHENG贸盛 Miller米勒
Miller米勒 新世纪焊接
新世纪焊接 西安恒立
西安恒立 上海特焊
上海特焊 新天激光
新天激光 海目星激光
海目星激光 迅镭激光
迅镭激光 粤铭YUEMING
粤铭YUEMING 镭鸣Leiming
镭鸣Leiming 领创激光
领创激光 天琪激光
天琪激光 亚威Yawei
亚威Yawei 邦德激光bodor
邦德激光bodor 扬力YANGLI
扬力YANGLI 宏山激光
宏山激光 楚天激光
楚天激光 百超迪能NED
百超迪能NED 金运激光
金运激光 LVD
LVD Tanaka田中
Tanaka田中 BLM
BLM 易特流etal
易特流etal 百盛激光
百盛激光 Messer梅塞尔
Messer梅塞尔 PrimaPower普玛宝
PrimaPower普玛宝 创力 CANLEE光纤激光切割机
创力 CANLEE光纤激光切割机 全自动焊接流水线
全自动焊接流水线 大焊 焊机匠心品质 精工之作 行家之选
大焊 焊机匠心品质 精工之作 行家之选 KUKA 库卡摩多机器人流水线作业
KUKA 库卡摩多机器人流水线作业 松下 旗下LAPRISS机器人激光焊接系统
松下 旗下LAPRISS机器人激光焊接系统 川崎工业焊接机器人 焊接管架
川崎工业焊接机器人 焊接管架 上海通用电气 全焊机系列展示
上海通用电气 全焊机系列展示 广州烽火WSM-400L(IGBT)逆变式直流脉冲氩弧焊机
广州烽火WSM-400L(IGBT)逆变式直流脉冲氩弧焊机 沪星BX6-200 电焊机 小型便携式电焊机 BX6-200 交流家用电焊机 不锈钢广菱电焊机
沪星BX6-200 电焊机 小型便携式电焊机 BX6-200 交流家用电焊机 不锈钢广菱电焊机 佳士TIG200S家用逆变直流氩弧电焊机
佳士TIG200S家用逆变直流氩弧电焊机 膨胀型阻火模块供应 国标电力封堵防火砖厂家直销
膨胀型阻火模块供应 国标电力封堵防火砖厂家直销 供应逆变交直流脉冲氩弧焊机
供应逆变交直流脉冲氩弧焊机 凯尔达WS-T250N氩弧焊机
凯尔达WS-T250N氩弧焊机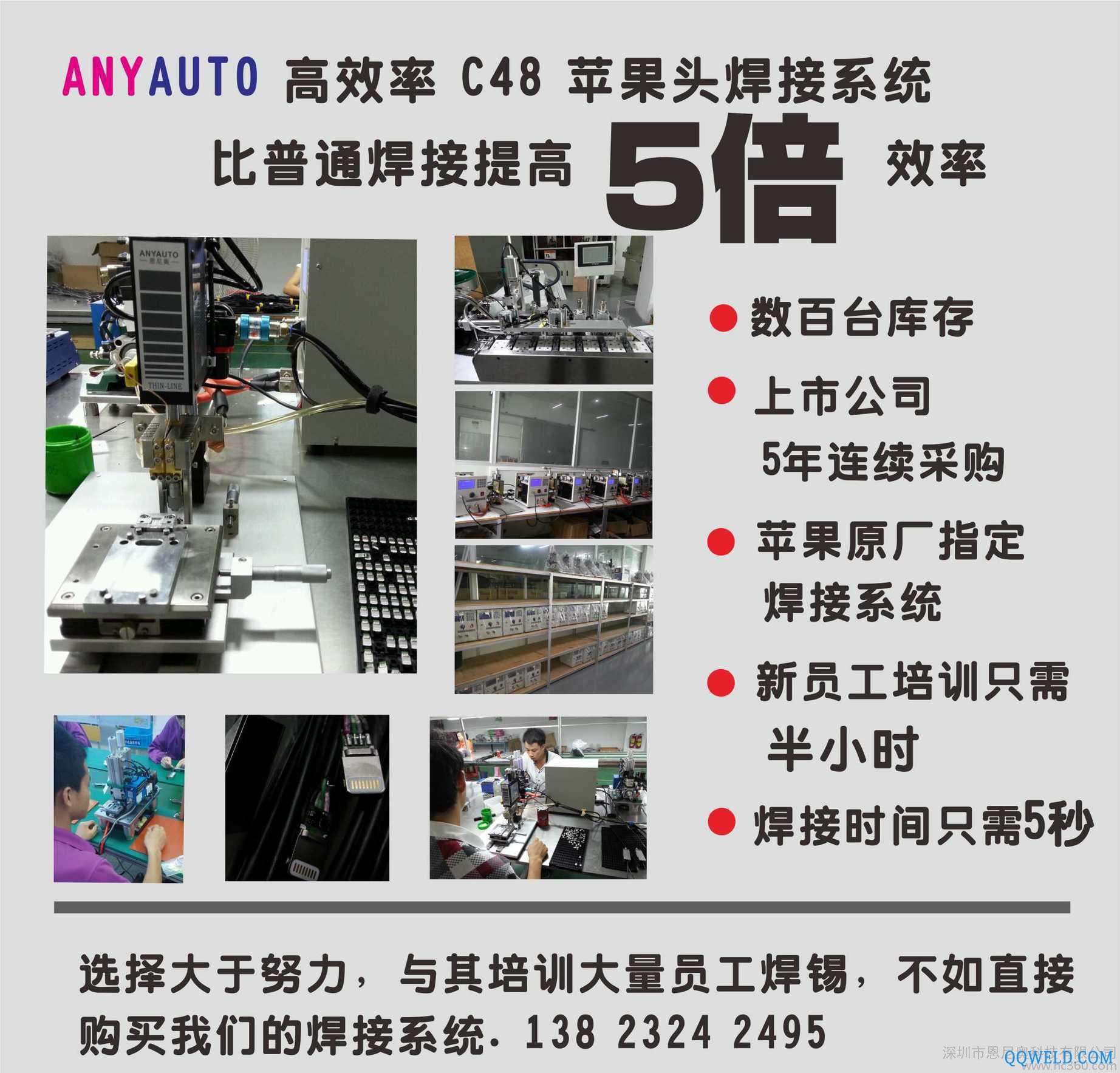 自动焊接机器人,深圳自动焊接机器人工厂在那里
自动焊接机器人,深圳自动焊接机器人工厂在那里 300A柴油发电电焊机_大泽TO300A发电焊机
300A柴油发电电焊机_大泽TO300A发电焊机








